- DME Channel auf YouTube

Mittels konventioneller Lichtmikroskope lässt sich wegen der Wellennatur des Lichts maximal eine ca. 800 bis 1000 fache Vergrößerung erreichen. Jenseits davon verwendet man Elektronenmikroskope, von denen die Klasse der Transmissions-Elektronenmikroskope (TEMs) einzelne Atome sichtbar machen kann und damit die maximal mögliche Vergrößerung überhaupt erreicht. Weshalb also existiert mit dem Rastersondenmikroskop (oder auch Scanning Probe Microscope, SPM) überhaupt noch eine weitere Art von Mikroskop?
Ein Grund dafür ist, dass eine Probe, um sie in einem Transmissionselektronenmikroskop
untersuchen zu können, in feine Scheiben geschnitten und damit zerstört werden muss. Die SPM-Technik
bildet Oberflächenstrukturen mit atomarer (Höhen-) Auflösung ab, ohne dass dafür die Probe
zerstört werden muss.
Ein weiterer Grund ist die Art der Abbildung: Rastersondenmikroskope bilden Oberflächen ab, erzeugen somit
eine Art dreidimensionales Bild (auch wenn nur zweidimensionale Informationen ausgewertet werden). Wie auch mit
Lichtmikroskopen ist es mit Elektronenmikroskopen schwierig, die Oberflächenstruktur einer Probe zu
untersuchen. Um ein Oberflächenprofil mit höchster Auflösung zu messen, muss auch hier die Probe
zerschnitten werden.
Des Weiteren funktioniert ein SPM ohne Vakuum und kann im Vergleich zu Elektronen- oder Lichtmikroskop
andere physikalische Effekte messen. Darunter fallen elektrische Eigenschaften
wie z.B. Austrittsarbeiten (Kelvin-Probe-Force-Microscopy, KPM / KPFM) oder magnetische
Eigenschaften (Magnetic Force Microscopy, MFM).
Es existieren zwei Haupttypen von Rastersondenmikroskopen: Rastertunnelmikroskope (STMs) und
Rasterkraftmikroskope (AFMs).
Gemeinsam ist beiden, dass eine feine Spitze als Sensor mechanisch nahe über der Probe, d.h. mit einem
Abstand von wenigen Nanometern, in einem Raster hin- und herbewegt, die Probe wird gescannt.
Während des Scannens wird die Oberfläche normalerweise "abgetastet" und aus dieser
Information wird das Bild der Oberfläche erzeugt. Für die Scanbewegung kann entweder die Probe oder
die Spitze bewegt werden. Im erstem Fall spricht man von einem Spitzenscanner, engl. Probescanner;
im zweiten Fall von einem Probenscanner, engl. Sample Scanner.
Die Art des Abtastens unterscheidet sich bei STMs und AFMs:
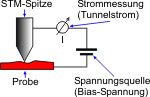
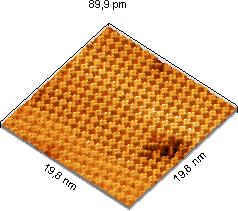
- Atomar aufgelöste STM-Messung
Schwefelatome auf einer Cu100-Oberfläche
(Messung durchgeführt an der TU Dänemark)
Das STM ist das einfachere Prinzip und funktioniert nur bei leitfähigen Proben: Eine Metallspitze,
sowie die Probe werden mit einer Spannungsquelle verbunden. Die STM-Spitze wird nun so nah an die Probe gebracht,
dass ein Strom fließt, ein sogenannter Tunnelstrom. Es besteht ein exponentieller Zusammenhang
zwischen Abstand Spitze, Probe und Stromfluss. Im Allgemeinen wird nun während des Scanvorgangs der Abstand
zwischen Probe und Spitze permanent so eingestellt, dass der Strom einen bestimmten konstanten Wert erreicht,
wozu während des Scannens die Spitze auf und ab bewegt werden muss. Die dazu notwendige Auf- und Abbewegung
der Spitze (bzw. der Probe) wird elektronisch aufgezeichnet und lässt sich als Bild darstellen.
Obwohl dieses Prinzip sehr einfach ist, liefert es sofort die maximal mögliche Vergrößerung und
erlaubt die Untersuchung und Manipulation einzelner Atome. Verantwortlich dafür ist eine Art selbstfokussierender
Effekt: Der für die Abbildung verantwortliche Tunnelstrom fließt gerade über das Atom, das sich
der Probenoberfläche am nächsten befindet. Bei einer flachen Probe erhält man deshalb auch
mit einer Kneifzange abgeknipsten Drahtspitze atomare Auflösung.
Die für STM-Messungen verwendeten Spannungen liegen normalerweise unter 1 V, da die durch die feine Spitze zwischen Probe und Spitze auftretenden elektrischen Felder sehr groß sind. Eine Spannung von 5 V verursacht bereits eine Ablösung bzw. eine Veränderung der Spitze. Durch einen 5 V Puls kann auch eine Art Reinigungseffekt der Spitze erzielt werden.
Die Tunnelströme liegen im nA-Bereich und der Abstand zwischen Spitze und Probe liegt bei wenigen nm.
STM-Messungen erfordern, dass eine Probenoberfläche atomar "sauber" ist. An Luft gelingt es
nur mit bestimmten Proben, atomar aufgelöste Bilder zu erzeugen. Oftmals lagern sich an Luft unerwünschte
Moleküle bzw. Atome an der Oberfläche an, die eine Aufnahme der eigentlichen Struktur verhindern.
Am einfachsten lassen sich Atomgitter an HOPG-Proben (highly oriented pyrolytic graphite) beobachten,
da sich die oberste Schicht mit einem Tesafilmstreifen entfernen lässt und man für kurze Zeit eine
atomar "saubere" Oberfläche erhält. Diese Proben werden deshalb oft als Teststrukturen
für das STM verwendet und auch unsere DME-STMs werden an HOPG-Proben auf ihre Funktion überprüft.
Beim Scannen arbeitet das STM sehr schnell. Es werden hier bei atomar aufgelösten Bildern gewöhnlich
Scanraten von mehreren Bildern pro Sekunde erzielt.


- Atomare Stufen von Strontium-titanoxid, Stufenhöhe 0,78 nm
Messung stammt vom Institut f. elektr. Messtechnik, TU Braunschweig
Das AFM verwendet eine andere Art der Abtastung. Hier verwendet man als Sensor einen dünnen Balken mit einer feinen Spitze am vorderen Ende, genannt Cantilever. Man lässt einen Laserstrahl auf die Oberseite des Cantilevers treffen und von dort in einen Positionsdetektor reflektieren. Auf diese Weise kann man die Verbiegung des Cantilevers messen. Die Länge des Cantilevers liegt bei einigen hundert Mikrometern, die Dicke aber nur bei einigen Mikrometern. So sind nur ganz geringe Kräfte notwendig, um den Cantilever zu verbiegen. Diese Kraftmessung kann man nun dazu verwenden, die Oberfläche einer Probe mechanisch abzutasten.
Im Gegensatz zum STM kann das AFM somit auch bei elektrisch nicht leitfähigen Proben verwendet werden. Das AFM hat verschiedene Betriebsmodi: Der einfachste ist der sogenannte Kontaktmodus, oder auch DC-Modus. Hier wird versucht, während des Scanvorgangs die Cantileverbiegung, d.h. die Kraft, mit der der Cantilever auf die Probe drückt, konstant zu halten, und der Cantilever entsprechend mechanisch auf- und abbewegt. Die Auf- und Abbewegung wird wie beim STM aufgezeichnet und man erhält ein Bild der Oberfläche. Die hierbei zwischen der Probe und Cantilever auftretenden Kräfte liegen im Bereich von Nanonewton. Diese Kräfte sind oftmals zu groß für die Probe und führen auch zu einem Abrieb der Cantileverspitze.
Deshalb wird heutzutage ein Rasterkraftmikroskop normalerweise in AC-Modus betrieben.
Hierzu "schüttelt" man den Cantilever mit seiner Resonanzfrequenz, so dass er permanent auf- und
abschwingt. Dadurch oszilliert auch der Laserstrahl und die Detektorspannung, und man kann so ein elektrisches
Signal proportional zur mechanischen Oszillationsamplitude des Cantilvers messen.
Für die Anregung mit der Resonanzfrequenz ist nur eine ganz geringe Energiezufuhr notwendig, d.h. der
Cantilever schwingt bereits bei sehr geringem "Schütteln" sehr stark. Bringt man den schwingenden
Cantilever in die Nähe der Probenoberfläche, wird die Cantileverschwingung bereits bei sehr geringen
Kräften zwischen Probe und Cantilever gedämpft. Die hierbei auftretenden Kräfte zwischen Probe
und Cantilever sind etwa ein bis zwei Größenordnungen kleiner als im Kontaktmodus (bei etwa 0,1 nN).
Das führt zu weniger Beeinflussungen der Probenoberfläche und schont die Cantileverspitze. Gleichzeitig
hat dieser Betriebsmodus keinen nennenswerten nachteiligen Einfluss auf die Auflösung und wird deshalb
meistens verwendet.

Bevor man mit einem Cantilever im AC-Modus messen kann, muss die Resonanzfrequenz festgestellt werden. Dazu
wird das Frequenzspektrum gemessen (d.h. die Oszillationsamplitude bei vielen verschiedenen Frequenzen).
Jeder Cantilever hat mehrere Resonanzfrequenzen, da er in verschiedene Richtungen und auf
verschiedene Arten schwingen kann. Man muss nun die Frequenz finden, bei der die Cantileverspitze am stärksten
auf und abschwingt. Ein weiteres Charakteristikum ist das Verhältnis von Höhe zu Breite des Resonanzpeaks,
Q-Faktor genannt. Der Scanner arbeitet umso empfindlicher, je größer der Q-Faktor der betreffenden
Resonanzfrequenz ist. Der Q-Faktor ist ein Maß für die Güte eines schwingenden Systems und
hängt mit der Dämpfung des Schwingers zusammen. Beim Cantilever als Schwinger tritt die geringste
Dämpfung auf, wenn die gesamte Spitze schwingt. Eine gute Regel für die Auswahl der richtigen
Resonanzfrequenz ist somit, den Peak mit dem höchsten Q-Faktor im Bereich der niedrigsten auftretenden
Resonanzen zu wählen. Heutzutage geschieht das Vermessen des Frequenzspektrums und die Auswahl des richtigen
Peaks normalerweise automatisch ohne Benutzereingriff. Insofern ist das Arbeiten im AC-Modus nicht aufwendiger
als im DC-Modus.
Die Diagramme auf der rechten Seite zeigen einen Screenshot des DME-SPM-Programms mit dem Frequenzspektrum eines
Cantilevers und dem gefundenen Peak. Die rote Kurve stellt die Oszillationsamplitude dar, die grüne Kurve
die Phasenverschiebung.
Nahezu alle Rasterkraftmikroskope können atomare Höhenstufen auflösen. AFMs können auch eine laterale atomare Auflösung erreichen. Dies stellt jedoch besondere Anforderungen an die Spitzengeometrie und ist mit normalen Cantilevern mit Spitzenradien um 10 nm nur sehr schwer möglich. Das STM hat hier den eindeutigen Vorteil, dass der Tunnelstrom genau über das Atom fließt, das der Probenoberfläche am nächsten ist. Diese Art der "selbstfokussierung" tritt beim AFM nicht auf. AFMs mit lateraler atomarer Auflösung werden nur in Spezialfällen eingesetzt, wo das Erreichen lateraler atomarer Auflösung wichtiger ist als die Einbußen an Flexibilität, die die erhöhte Stabilität des gesamten Aufbaus mit sich bringt. Gewöhnliche AFMs sind für relativ große Scanflächen (50 bis 200 µm Seitenlänge) ausgelegt und die Scanplattformen lassen die Untersuchung vieler verschiedener Probentypen und -größen zu.
STMs dagegen sind normalerweise fest in eine hochstabile Scanplattform integriert und die Seitenlängen der maximalen Scanflächen liegen bei 0,5 bis 10 µm. Die benötigte Stabilität der Scanplattform lässt wiederum i.A. nur kleine Probengrößen und Dicken zu. Oftmals werden STMs im Ultrahochvakuum eingesetzt, so dass eine einmalig präparierte Probenoberfläche einige Zeit lang ihren Zustand beibehalten kann.
Neben der Topographie können Rastersondenmikroskope auch andere physikalische Parameter messen. Beispielsweise können während des Scannens mit dem AFM gleichzeitig ein Stromfluss gemessen, die Phasenverschiebung der Cantileveroszillation oder viele andere Informationen ausgewertet werden. Es können auch an bestimmten oder jedem Punkt der Probe ganze Spektren, beispielsweise U/I-Kurven oder anderes Informationen aufgenommen oder auch die Oberfläche manipuliert werden. Das optische Nahfeldmikroskop (SNOM) ist beispielsweise ein erweitertes AFM, bei dem zusätzlich die Probe mit einem nanometergroßen Lichtfleck beleuchtet und detektiert werden können. Mit einer elektrisch leitfähigen, exakt positionierbaren, biegbaren Spitze lassen sich eben eine Menge physikalischer Parameter messen.
