- DME Channel auf YouTube

- Video in größerer Auflösung zeigen
Das BRR ist eine Verschmelzung von Rasterelektronenmikroskop und Rastersondenmikroskop.
Es vereinigt die besten Eigenschaften beider Welten, ohne Kompromisse bei der Leistungsfähigkeit
der Einzelkomponenten einzugehen. Zudem bietet das Kombinationsgerät zahlreiche Vorteile, welche die Geräte
allein nicht aufweisen können.
Das von uns entwickelte System ist als SEM-AFM-Integration für Zeiss GeminiSEM und Crossbeam. Eine nachträgliche Aufrüstung bestehender (auch älterer) Zeiss-Systeme ist jederzeit möglich.

- Das System basiert auf dem DME UHV-AFM und der Carl Zeiss AURIGA®-Crossbeam-Workstation.
- Kombinationsmessungen mit allen drei Geräten an exakt dem selben Punkt sind mit nanometergenauer Präzision möglich.
- Die AFM-Komponente ist für einzelatomare Auflösung in alle drei Raumrichtungen entwickelt bei gleichzeitiger Verfahrmöglichkeit der Probe relativ zur Spitze.
- Der Scanbereich der AFM-Einheit liegt bei 10x10x1 µm.
- Eine extrem hohe Stabilität des AFMs wird durch eine kompakte Cantilever-Probe-Scannereinheit gewährleistet.
- Für einzigartigen Bedienkomfort sorgt ist eine einheitliche Softwareoberfläche für AFM und Elektronenmikroskop und eine gemeinsame Speicherung von AFM- und Elektronenmikroskopbildern.
- Die AFM-Komponente des SEM-AFM ist mit klassischer Laser-Reflektions-Detektion bei gleichzeitig äußerst geringem SEM-Arbeitsabstand von 5 mm realisiert.
- Bei Cantileverwechsel werden Laser und Detektor automatisch justiert.
- Das System ist um die Cantileverspitze bis zu ca. 85° rotierbar, was sowohl den Blick von oben auf die Spitze als auch den seitlichen Blick zwischen Spitze und Cantilever erlaubt.
- Der Schnittpunkt zwischen Elektronenstrahl und Focussed Ion Beam (FIB) befindet sich direkt an der Cantilever Spitze.
- Probenoberfläche und Spitze sind in 0° und 54° Position mit dem FIB erreichbar, wobei In-Situ-Anspitzen des Cantilevers mittels FIB unterstützt wird.
- Alle allgemeinen AFM-Betriebsmodi werden unterstützt.
- Weitere Details in englisch (pdf)
 Warum ein kombiniertes SEM-AFM? Ein kombiniertes SEM-AFM-System bietet zahlreiche Vorteile,
die die Einzelkomponenten allein nicht aufweisen.
Warum ein kombiniertes SEM-AFM? Ein kombiniertes SEM-AFM-System bietet zahlreiche Vorteile,
die die Einzelkomponenten allein nicht aufweisen.
Das System eröffnet völlig neue Möglichkeiten in der Untersuchung von Oberflächen
und in der Nanostrukturanalyse. Die Kombination der hoch auflösenden elektronenoptischen
Mikroskopie mit AFM ermöglicht eine nanometergenaue Positionierung der AFM Spitze. Das AFM
liefert punktgenau Information über topographische, elektrische und mechanische
Eigenschaften der Oberfläche. Verschiedenste Beobachter-, Modulator Rollenverteilungen
zwischen SEM, AFM und FIB sind denkbar, welche die Untersuchung auch völlig neuer
physikalischer Phänomene ermöglicht.
Weitere Messungen zeigen unsere Videos und die Anwendungensbeispiele.
Mehr zu den Vorteilen können Sie in unserem Artikel SEM und AFM – Hochauflösung mit Übersicht nachlesen.
Unser Ansatz zur Entwicklung eines kombinierten SEM-AFM-Systems lag in der Integration eines vakuumkompatiblem AFM in bestehende SEM-Systeme. Diese Strategie wurde gewählt, um möglichst hohe Bedienerfreundlichkeit zu erreichen und Nutzern von SEMs eine Möglichkeit zur Erweiterung ihrer bereits vorhandenen SEM-Systeme zu bieten. Dabei bleibt die gesamte Funktionalität des SEM erhalten und kann zeitgleich mit dem AFM betrieben werden, so dass kombinierte Messungen möglich sind.
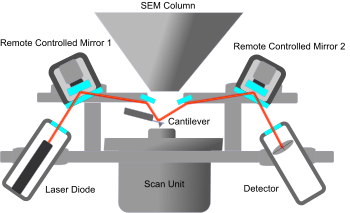
- Laserpfad
Das für die Integration entwickelte AFM ist als Probenscanner ausgelegt (Probe bewegt sich
beim Scannen, der Cantilever steht still), da es so möglich ist, die AFM Spitze auch
während des Scannens einen konstanten Abstand zwischen Spitze und Elektronenstrahl einzuhalten.
Das Konzept des Probenscanners ermöglicht zudem einen wesentlich einfacheren Cantilever und
Probenwechsel.
Der Scanner ist eine Weiterentwicklung unserer STM-Scanner, welche schon seit Jahrzehnten höchste
Auflösung und Verlässlichkeit beweisen.
Sämtliche Elektronik, wie der Vorverstärker, sowie Laser und Photodiode zur Detektion der
Cantileverauslenkung befinden sich direkt am Gerät und sind durch Kapselung vom Vakuum getrennt.
Die Justage des Laserpfades wird durch von außen bedienbare, motorisierte Spiegeleinheiten
ausgeführt. Zur groben XYZ-Positionierung von Probe zu Spitze ist unterhalb der AFM-Einheit
eine motorisierte Positioniereinheit verbaut. Mit wenigen Modifikationen ist auch eine UHV-fähige
Version des beschriebenem AFM erhältlich.

Dieses System stellt eine Integration des von DME entwickelten AFMs in einem AURIGA®-System
der Firma Carl Zeiss dar. Hierbei befindet sich die Cantileverspitze im im Schnittpunkt
zwischen Elektronenstrahl und FIB (Focused Ion Beam), im "Crossbeampoint" des Auriga Systems.
So kann der Operator SEM, AFM und FIB an ein und dem selben Punkt betreiben.
Bei der Anwendung kommt der Rotationsachse eine besonders wichtige Rolle zu teil.
Durch sie kann das AFM um ca. 85° um den Crossbeampoint rotiert werden. Damit wird es
möglich, entweder den Elektronenstrahl oder den FIB senkrecht zur Probe auszurichten.
Zudem ermöglicht diese Bewegung auch die seitliche Betrachtung der AFM Spitze mittels
SEM und FIB, und das mit kommerziell erhältlichen Standardcantilevern. Der direkte Blick
auf die Sensorspitze wäre ohne die Rotationsmöglichkeit beim Blick
von oben bei den meisten Cantilevertypen durch den Cantilever selbst versperrt.
Das technische Design des Systems ermöglicht dem Benutzer den parallelen Einsatz aller
drei Messverfahren in verschiedensten Manipulator-Beobachter Rollenverteilungen.
Die Funktionalität komplexer Instrumente wird zu einem großen Teil durch die
Betriebssoftware definiert. Um der angestrebten nahtlosen Integration gerecht zu werden,
sind SEM und AFM über ein und die selbe Softwareoberfläche angesteuert,
unserer ScanTool™ Software.
Hierzu wurde eine eigens entwickelte SEM-Steuerungssoftware in unsere Standard AFM-Software ScanTool™
integriert. Dadurch bietet die ScanTool™-Benutzeroberfläche direkten Zugriff auf alle
Steuerungsparameter des gesamten SEM-AFM-Systems. Ein schnelles Arbeiten mit SEM und AFM im
einzelnen wie auch im in kombinieren Betrieb sind so möglich.
Durch die Wahl unseres Dateiformats und der engen Vernetzung der Bediensoftware ist es
möglich, akquirierte Daten zusammen zu speichern und zu bearbeiten. Die Analyse von
Bilddaten, ob AFM oder SEM, können im ScanTool™ Programm durchgeführt werden.
Zusätzlich zu den in der Software verfügbaren Analysefunktionen besteht die
Möglichkeit über den ScanTool™ "Image Calculator" eigene Analysefunktionen zu generieren.
Auch die Erstellung kombinierter Bilder ist möglich, z.B. durch Erzeugung eines 3D-Bildes, bei der die
Dimensionsinformation aus der AFM Messung und die Texturierung aus der SEM Messung stammt.
Durch ihr offenes Design und den ScanTool™ "Automator" ermöglicht die Software
unvergleichliche Freiheiten in Zugriff auf Instrumentensteuerung und in der Definition von
automatisierten experimentellen Abläufen und Messroutinen. Kombinierte Messungen an
verschiedenen Probenarealen können so exakt gleich durchgeführt werden, um vergleichbare
Datensätze zu erhalten.

