- DME Channel auf YouTube
Das Prinzip eines AFM beruht auf der wechselwirkenden Kraft zwischen AFM-Spitze und Probenoberfläche,
wenn beide sich bis auf einen geringen Abstand annähern. Die Krafteinwirkung auf den Cantilever wird
mit einem Laser-Detektions-System gemessen. Dazu lässt man einen Laserstrahl auf die Oberseite des
Cantilevers treffen und von dort in einen Positionsdetektor reflektieren. Auf diese Weise kann man die
Verbiegung des Cantilevers messen.
Um ein Oberflächenprofil zu messen, wird der Cantilever parallel über die Oberfläche
bewegt, also in x-y-Richtung und trifft dabei auf Oberflächenstrukturen. Dies führt zu einer
Änderung der wechselwirkenden Kraft zwischen AFM-Spitze und Probenoberfläche.
Der Abstand zwischen Spitze und Probe in vertikaler Richtung (z-Richtung) wird mittles einer
Feedbackschleife nachgeregelt, in der das gemessene Sensorsignal mit einer vorgegebenen Sensor-Setpoint
verglichen wird. Die Differenz zwischen diesen beiden Werten ist das sogenannten Fehlersignal. Durch
Änderungen des Abstand zwischen Spitze und Probe wird der Fehler zu Null geregelt.
Sowohl die Z-Korrektur, als auch das Fehlersignal werden aufgezeichnet und können dargestellt werden.
Die Z-Korrektur spiegelt direkt die Topographie wider, während das Fehlersignal dem Gradienten der
Topographie entspricht.
Um eine rechteckige Fläche zu vermessen, wird diese Fläche in einzelne Zeilen zerlegt. Diese Zeilen werden dann zu einer dreidimensionalen Oberflächentopographie zusammengesetzt. Die Arbeitsweise des AFMs ermöglicht es, atomare Stufen auf der Probenoberfläche aufzulösen, die laterale Aufösung korreliert direkt mit dem Radius der Cantileverspitze.
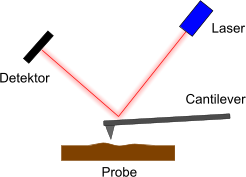
Der einfachste ist der sogenannte Kontaktmodus, oder auch DC-Modus. Hier wird versucht, während des Scanvorgangs die Cantileverbiegung, d.h. die Kraft, mit der der Cantilever auf die Probe drückt, konstant zu halten, während sich der Cantilever entsprechend mechanisch auf- und abbewegt. Die Auf- und Abbewegung wird aufgezeichnet und man erhält ein Bild der Oberfläche. Die hierbei zwischen der Probe und Cantilever auftretenden Kräfte liegen im Bereich von Nanonewton. Diese Kräfte sind oftmals zu groß für die Probe und führen auch zu einem Abrieb der Cantileverspitze.
Es gibt zwei DC-Modus-Variationen: Im "constant height mode" wird der Cantilever in einem Abstand zur Probenfläche gehalten, so dass die Kraft nachgeregelt wird. Die Änderung der Kraft wird aufgezeichnet und in ein Abbild der Topographie umgewandelt. Im "constant force mode" hingegen wird die Kraft und somit die Auslenkung des Cantilevers konstant gehalten, indem der Abstand zwischen Spitze und Probenoberfläche variiert wird. Diese Variationen ergeben dann ein Abbild der Topographie.
Zusätzlich zu diesen beiden Modi, kann auch die laterale Torsion des Cantilevers gemessen und in Topographiewerte umgerechnet werden.
Mögliche Anwendungen: Topographiemessungen

Um den Cantilever zu schonen, werden AFMs meistens in dem sogenannten AC-Modus betrieben. Dieser Modus
benötigt nur geringe Kräfte zum Scannen, ohne dabei an Auflösung zu verlieren.
Der Cantilever wird in mit seiner Resonanzfrequenz angeregt und schwingt die ganze Zeit. Diese
Oszillation führt zu einer periodischen Auslenkung des Cantilevers, die von einem reflektierten
Laserstrahl gemessen werden kann, wie auch im DC-Modus. Wenn der Cantilever sich in der Nähe der
Oberfläche befindet, wechselwirkt er mit den Atomen der Oberfläche, so dass sich die
Resonanzfrequenz ändert. (Die Resonanzfrequenz wächst bei Annäherung an die Probenoberfläche.)
Dies führt zu eine Däpfung der Amplitude und einer Phasenverschiebung der Cantileveroszillation.
Die Wechselwirkungskraft zwischen Spitze und Probe und die Dämpfung der Cantileversozillation sind
nahezu proportional, wenn die Spitze sich in unmittelbarer Nähe zur Probe befindet.
Sowohl die Dämpfung der Amplitude als auch die Phasenverschiebung der Cantileveroszillation liefern ein Bild der Topographie. Standartmäßig wird in unserer Software die Dämpfung benutzt, um die Topographie darzustellen. Die Phase kann zusätzlich aufgezeichnet werden.
Das Proportionalitätsintervall zwischen dem Punkt, an dem die Kraft ansteigt, und der vollständigen
Oszillation hängt von der Oszillationsamplitude und dem Q-Faktor, also dem sogenannten
Qualitätsfaktor der Oszillation der Spitze ab. Der Q-Faktor beschreibt das Verhältnis zwischen
Höhe und Breite des Resonanzpeaks. Der Scanner ist empfindlicher bei einem höheren Q-Faktor.
Jeder Cantilever hat mehr als eine Resonanzfrequenz, da er in verschiedene Richtungen auf verschiedene Arten
schwingen kann. Es gilt nun die Resonanzfrequenz zu finden, bei der die Oszillation der Cantileverspitze am
stärksten ist. Eine gute Regel dafür ist, den Peak mit dem höchsten Q-Faktor in der Nähe
der kleinsten Resonanzfrequenz auszuwälen,
Der AC-Modus hat gegenüber dem DC-Modus einige Vorteile:
- Die Oberfläche wird weit weniger durch die Messung beeinflusst aufgrund der geringen Wechselwirkungskräfte.
- Aufgrund der geringen Beanspruchung haben die einzelnen Cantilever eine längere Lebensdauer.
- Fragile Proben, die bei DC-Messungen unter Umständen zerstört werden, können problemlos im AC-Modus vermessen werden.
- Die Abhängigkeit Phasenverschiebung/Dämpfung ist charakteristisch für jedes Oberflächenmaterial und liefert somit noch zusätzliche Informationen.
Für jeden Modus werden unterschiedliche Cantilever verwendet: Cantilever für den DC-Modus sind länger und dünner als Cantilever für den AC-Modus, um eine stärkere Ablenkung bei kleinen Kräften zu bekommen. Um den Amplitudensozillation zu minimieren und den Q-Faktor zu erhöhen, sind Cantilever für den AC-Modus kürzer und dicker.
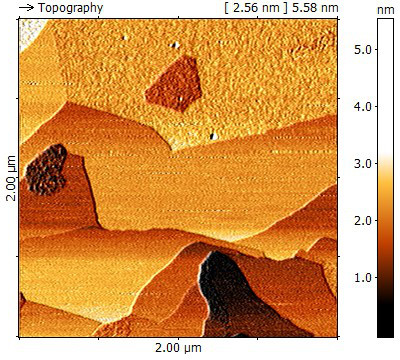
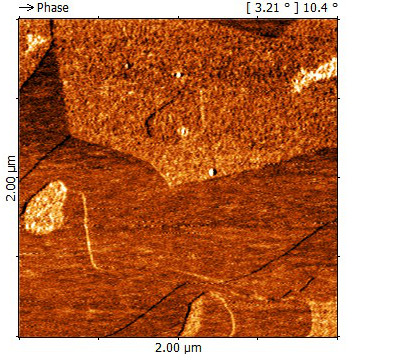
SiC und Graphen-Atomlagen: Topographie (links) und Phasen (rechts) von SiC-Atomlagen wurden gleichzeitig gemessen.
Mögliche Anwendungen: Topographiemessungen
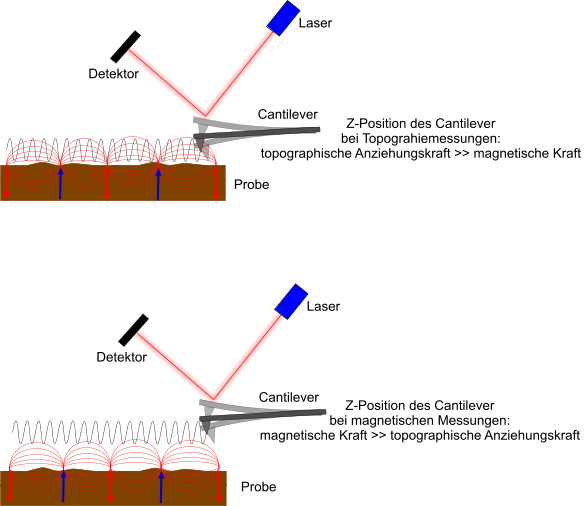
Um magnetsiche Strukturen zu detektieren, benötigt man einen Cantilever, der mit einer magnetischen Beschichtung versehen ist. Der Radius von Standart-MFM-Spitzen ist aufgrund ihrer relativ dicken Beschichtung mit ungefähr 50 nm wesentlich größer als der konventioneller AFM-Spitzen. Mit diesen Standart-MFM-Spitzen kann man eine laterale magnetische Auflösung von ca. 100 nm erreichen, im Gegensatz zu den AFM-Topographiemessungen mit einer 10 Mal besseren Auflösung.
Wenn sich die Spitze der Probe nähert, treten sowohl mechnische als auch magnetische Kräfte auf,
die auf den Cantilever wirken. Die magnetischen Kräfte sind wesentlich kleiner als die mechanischen,
haben aber eine größere Reichweite. Um die beiden Kräften voneinander zu trennen, wird
die MFM-Messung in einem größeren Abstand zur Probe durchgeführt, wo die mechanischen
Kräfte vernachläßgt werden können.
Dies führt zu folgenden Messprinzipien:
- Für jede eingescannte Zeile des AFM-Bildes wird erst die Topographie gemessen.
- Die Spitze wird in einem bestimmten Abstand von der Oberfläche positioniert. Dann wird die gleiche Zeile noch mal gemessen unter Berücksichtigung der vorhergehenden Topographiemessung.
- Cantilever-Auslenkung:
- Die magnetischen Kräfte verursachen eine Auslenkung des Cantilevers, die von der Stärke des Magnetfeldes abhängt. Bei geringen magnetischen Kräften empfiehlt es sich, einen Cantilever mit einer kleinen Kraftkonstante zu wählen. Normalerweise wird diese Art von Messung im DC-Modus durchgeführt, da es sonst keine andere Möglichkeit gibt die magnetische Kraft zu messen.
- Im AC-Modus wird die Auslenkung von der Spitzenoszillation überlagert. Um den Oszillationsanteil zu eleminieren, wird das Signal durch einen Tiefpassfilter geschickt.
- Die magnetischen Kraftmessungen mittels Cantileverauslenkung haben die geringste Empfindlichkeit.
- Dämpfung der Oszillationsamplitude:
- Im AC-Modus verursacht das Magnetfeld eine Dämpfung der Cantileveroszillation, so dass auch die Amplitudenoszillation gemessen werden kann.
- Diese Methode hat eine mittlere Empfindlichkeit.
- Änderung der Oszillationsphase:
- Im AC-Modus wird auch die Phasenverschiebung der Cantileveroszillation durch das Magnetfeld geändert. Die Phase der Oszillation reagiert wesentlich empfindlicher auf äußere Käfte als die Oszillationsamplitude. Messungen der Oszillationsphase ist die beste Methode, um hochqualitative MFM-Messungen durchzuführen.
Es gibt verschiedene magnetische Cantilever, die sich in der Magnetisierung ihrer Spitze unterscheiden. Eine starke Magnetisierung der Spitze kann unter Umständen zu einer Änderung einer schwachen Magnetisierung der Probe führen. Auf der anderen Seite reagiert eine stark magnetisierte Spitze empfindlicher auf die Magnetisierung der Probe. Somit muss man abwägen zwischen der Bildqualität und der maximalen Magnetfeldstärke.


Magnetischer Stahl: Topographie (links) und Magnetische Information (rechts) wurden gleichzeitig gemessen.
Mögliche Anwendungen: Messungen magnetischer Proben
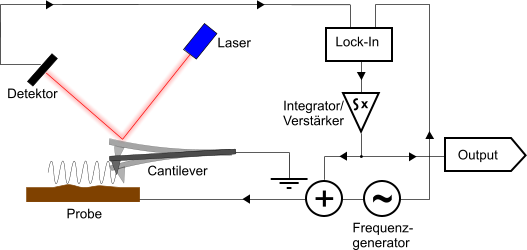
Mit dieser Meßmethode läßt sich das chemische Potential zwischen Cantilever und
Probenoberfläche bestimmen, das einem Informationen über das Material und den Materialzustand
liefer.
Der Aufbau einer KPFM-Messung ist in der Abbild zu sehen. Die Probe wird elektrisch mit dem Ausgang des
Frequenzgenerators verbunden. Dies erzeugt ein oszillierendes, elektrische Feld zwischen Cantilever
und Probe, das mit dem Positionssensor des AFM gemessen werden kann. Das detektierte Signal wird zurück
an den Lockin-Verstärker gegeben und anschließend integriert. Das Ergebnis wird als konstanter
Offset auf die Oszillation addiert, die an der Probe anliegt. Diese Feedback-Schleife minimiert die
elektrisch induzierte Cantileveroszillation.
Beim Anlegen einer Spannung zwischen Cantilever und Probe tritt eine elektrostatische Kraft am
Cantilever auf, die beschrieben werden kann durch
F = -1/2 dC/dz V2
mit V = VDC - VCPD + VAC * sin(ωt).
Hierbei ist C die Kapazität, VDC gibt den konstanten und VAC den oszilierenden
Anteil der angelegten Spannung an, VCPD ist die Spannung, die beim Annähern der Ferminiveaus
des Cantilevers und der Probenoberfläche auftritt (Kontaktpotentialdifferenz).
Setzt man die Spannungen in die Kraftgleichung ein, ergibt sich ein längerer Term, der sich nach den
Frequenzen sortieren läßt:
F = FDC + Fω + F2ω.
Unter der Annahme, dass die Kapazität proportional zu 1/d ist, können die Terme von F geschrieben
werden als:
FDC ∝ C * (VDC-VCPD)2 + VAC2 /2,
Fω ∝ C * (VDC-VCPD) * VAC * sin(ωt),
F2ω ∝ C * VAC2 * cos(ωt).
Für die KPFM-Messung wird Fω benutzt: Wenn VDC gleich VCPD ist,
verschwindet diese Kraft. Somit korrespondiert der Output der Feedbackschleife mit VCPD, dem
chemischen Potential.
Für die Kapazitätsmessung verwendet man den Term F2ω, der direkt proportional zur
Kapazität zwischen Spitze und Probenoberfläche ist.
Für KPFM-Messungen werden leitende Cantilever benötigt, sie sogenannten EFM-Cantilever.
Diese sind länger als konventionale AC-Cantilever und liefern ein besseres Signal-Rauschen-Verhältnis,
weil sie im elektrischen Feld stärker reagierten.
Da Standartcantilever aus hochdotiertem Silizium gemacht werden, können diese auch für KPFM-Messungen
verwendet werden. Allerdings sollte dann darauf geachtet werden, dass der Cantilever elektrisch mit dem
AFM-Cantileverhalter verbunden ist.
Bei einer KPFM-Messung ist es wichtig, dass die richtige Frequenz gewählt wird. Diese sollte sich wenigstens
10 bis 20 kHz von der Arbeitsfrequenz des AFM-Scanners unterscheiden, um Interferenzen zwischen der normalen
Oszillation des AC-Modus und der elektrisch induzierten Oszillation zu vermeiden.
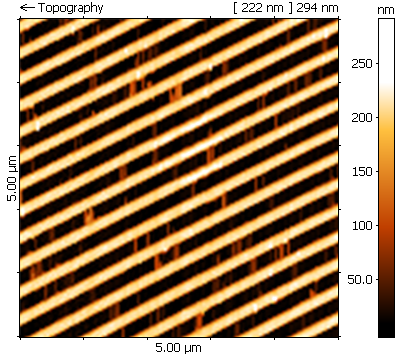
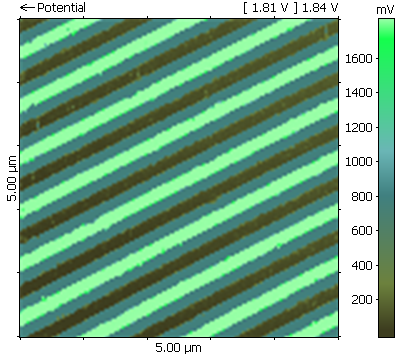

Multilayerkondensator: Topographie (links) und Austrittsarbeit (rechts) wurden gleichzeitig gemessen.
Überlagerung beider Bilder: 3D-Struktur = Topographie, Farbe = Austrittsarbeit
Mögliche Anwendungen Messung elektrischer Eigenschaften
Diese Messmethode wird verwendet, um die relativen Änderungen der Hauptladungsträgerkonzentration auf flachen Halbleiteroberflächen zu bestimmen. Die Kapazitätsmessung wird ähnlich der KPFM-Messung durchgeführt, es kann der gleiche Messaufbau verwendet werden. Der Hauptunterschied dabei ist, dass das Ausgangssignal vom Lock-In-Verstäker und nicht vom Feedbacksignal verwendet wird. Es wird also die Komponente F2ω der Kraft verwendet, wie oben bei der KPFM-Messung beschrieben. Diese Kraftkomponente ist proportional zur Kapazität C zwischen Spitze und Probenoberfläche.
Die Kapazitätsmessung liefert relative Werte. Die absolute Kapazität zwischen Spitze und leitender Probe liegt in der Größenordnung von aF (atto farad = 10^-18 farad), die Kapazität zwischen Cantileverkörper und Probe hingegen in der Größenordnung von fF (femto farad = 10^-15 farad). Diese kleinen Dimensionen und der große Offset zeigt, dass eine direkte Messung der Kapazität fast unmöglicht ist, und deshalb nur relative Werte gemessen werden können.
Eine KPFM-Messung ohne zu Null regulierenden Feedback wird EFM-Messung genannt, electrostatic force microscopy. Hierbei wird der Feedbackregulator ausgelassen und der Ausgang des Lock-In-Verstärkers direkt beobachtet. Diese Messmethode liefert, wie auch in der Gleichung Fω der obigen KPFM-Messung hergeleitet, eine Überlagerung an Informationen über das chemische Potential, die Wechselspannung, die Kapazität, etc. Deshalb ist die EFM-Messung weniger geeignet, um physikalische Eigenschaften zu bestimmen, als die KPFM-Messung.

Der STM-Modus ist der einfachste Modus und funktioniert nur an leitfähigen Proben. Anstelle eines
Cantilevers wird eine senkrechte Metallspitze verwendet. Sowohl Spitze als auch Probe werden mit einer
Spannungsquelle verbunden. Nun wird die STM-Spitze so dicht an die Probenoberfläche gefahren, dass
ein Strom fließen kann, der sogenannte Tunnelstrom. Zwischen dem Abstand Spitze-Probe und dem
Tunnelstrom besteht ein exponentieller Zusammenhang.
Es gibt zwei Scanmöglichkeiten: Im "constant height mode" wird die Höhe der Spitze
und die Spannung konstant gehalten, während der Tunnelstrom sich ändert. Diese Änderungen
werden in Topographiewerte umgerechnet. Im "constant current oder feedback mode" bewegt sich
die Spitze hoch und runter, um den Tunnelstrom konstant zu halten, so dass sich die Spitze in einem
konstanten Abstand über die Probenoberfläche bewegt. Die dazu notwendige Auf- und Abbewegung
der Spitze wird elektronisch aufgezeichnet und lässt sich als Bild darstellen.
Obwohl dieses Prinzip sehr einfach ist, liefert es sofort die maximal mögliche Vergrößerung und erlaubt die Untersuchung und Manipulation einzelner Atome. Verantwortlich dafür ist eine Art selbstfokussierender Effekt: Der für die Abbildung verantwortliche Tunnelstrom fließt gerade über das Atom, das sich der Probenoberfläche am nächsten befindet. Bei einer flachen Probe erhält man deshalb auch mit einer Kneifzange abgeknipsten Drahtspitze atomare Auflösung.
Die für STM-Messungen verwendeten Spannungen liegen normalerweise unter 1 V, da die durch die feine Spitze
zwischen Probe und Spitze auftretenden elektrischen Felder sehr groß sind. Eine Spannung von 5 V verursacht
bereits eine Ablösung bzw. eine Veränderung der Spitze. Durch einen 5 V-Puls kann auch eine Art
Reinigungseffekt der Spitze erzielt werden.
Die Tunnelströme liegen im nA-Bereich und der Abstand zwischen Spitze und Probe liegt bei wenigen nm.
STM-Messungen erfordern, dass eine Probenoberfläche atomar "sauber" ist. An Luft gelingt es
nur mit bestimmten Proben, atomar aufgelöste Bilder zu erzeugen.
Oftmals lagern sich an Luft unerwünschte Moleküle bzw. Atome an der Oberfläche an, die eine
Aufnahme der eigentlichen Struktur verhindern.
Am einfachsten lassen sich Atomgitter an HOPG-Proben (highly oriented pyrolytic graphite) beobachten, da sich
die oberste Schicht mit einem Tesafilmstreifen entfernen lässt und man für kurze Zeit eine atomar
"saubere" Oberfläche erhält. Diese Proben werden deshalb oft als Teststrukturen für das
STM verwendet und auch unsere DME-STMs werden an HOPG-Proben auf ihre Funktion überprüft.
Beim Scannen arbeitet das STM sehr schnell. Es werden hier bei atomar aufgelösten Bildern gewöhnlich
Scanraten von mehreren Bildern pro Sekunde erzielt.



Von links nach rechts:
Einzelatomar aufgelöste UHV-STM-Aufnahme., Uni Marburg.
Nanodots auf carbonisiertem Wolfram, UHV-STM., Physikalische Chemie, Uni Innsbruck.
Nanodots auf carbonisiertem Wolfram, UHV-STM., Physikalische Chemie, Uni Innsbruck.
Mögliche Anwendungen: Topographiemessungen
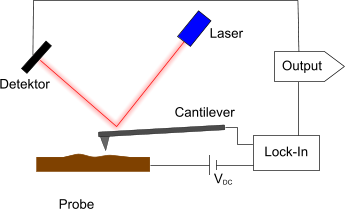
In dieser Messung wird auch eine leitende Probe verwendet. Im DC-Modus wird eine DC-Biasspannung angelegt und der elektrischer Strom zwischen Spitze und Probe gemessen. Der daraus resultierende Widerstand wird verursacht durch den Ausbreitungswiderstand und spezifischen Widerstand der Probe und liefert Informationen über die Ladungsverteilung.
Zu beachten ist, dass die Probenoberfläche mit der AFM-Spitze angekratzt wird, um einen besseren elektrischen Kontakt zu erzeugen.
Der typische Radius eines SPM-Sensors beträt ungefähr 10 nm. Somit ist es möglich Strukturen
in einer Größenordnung von wenigen Nanonmetern zu schreiben.
Eine Lithographie auftragen bedeutet, dass man die physikalischen oder chemischen Eigentschaften der
Probenoberlfläche ändern muss. Hier gibt es drei Möglichkeiten:
- die Probe Licht oder Elektronen aussetzen,
- Anlegen von hohen Drücken (scratching),
- Anlegen eines elektrischen Feldes.
Die Hauptidee der SPM-Lithographiefunktion ist es, die Informationen einer Bitmap mittels physikalischen Eigenschaften, wie Kraft, Spannung oder Strom, auf die Probenoberfläche zu übertragen. In Abhänhigkeit des Modus (AFM-AC, AFM-DC, STM), kann die physikalische Eigenschaft die Biasspannung oder der Strom sein (STM), Kraftänderungen (AFM) oder Spannung am Aux-Port des Controler (alle Modi). Die Aux-Spannung kann auch in viele andere physikalische Eigenschaften umgewandelt werden, indem man externe Geräte benutzt.
Die Oberfläche einer AFM-Spitze ist ungefähr 100nm groß. Drückt man nun eine Spitze mit einer Kraftkonstanten von 50 N/m 200 nm in Richtung der Oberfläche, dann ergibt sich daraus eine Kraft von etwa 10-5 N und einen Druck auf die Oberfläche von ungefähr 100 GPa. Das bedeutet, dass auf alle Fläche, die weicher als die Silikonspitze sind, Muster auf die Oberfläche übertragen werden können.


Mögliche Anwendungen: Lithographie
